
Mint ennek a számnak a szerteágazó témái is mutatják, a nanorendszer alatt számos, egymástól méretben, tulajdonságban igen eltérő képződményt értünk. Szűkítve ezt a túl általános definíciót, a következőkben olyan rendszerek vizsgálatáról fogunk beszélni, amelyeknél egy vagy több dimenzió abba a nagyságrendbe esik, ahol az anyagi tulajdonság némileg vagy erősen megváltozik a tömbi tulajdonságokhoz képest. Nyilván ezek a tulajdonságváltozások azok, amelyek a nanoszerkezetek divatossá válását indokolják - olyan anyagokat tudunk létrehozni, amelyek tömbváltozatban nem léteznek.
Az iparban a legrégebben és tömegméretekben használt nanorendszerben az egyik dimenzió mikroszkopikus, a másik kettő viszont makroszkopikus, azaz vékonyrétegek. Szinte lehetetlen olyan napjainkban gyártott eszközt találni, amely nem használ vékonyréteget mint fontos segítő elemet. Ha már két dimenzió van a mikroszkopikus tartományban, akkor jutunk a nanohuzalokhoz, ide tartoznak a nanocsövek, stb., majd három mikroszkopikus méret esetén a nanorészecskékhez.
A nanorendszerek széles spektrumának megfelelően a vizsgálati metodikák igen változatosak. Ha van egyáltalán általános módszer, akkor az a transzmissziós elektronmikroszkópia (TEM), aminek előnye vagy hátránya (például makroszkopikus minták vizsgálatánál), hogy nanoméretű térfogatról ad szerkezeti, morfológiai és kémiai információt.
A TEM néhányszor 10 nm vastagságú mintát képes átvilágítani, de jó minőségű információt tud szolgáltatni már néhány nanométer vastag tartományról is. A laterális felbontás néhány tized nanométer is lehet. Ezek a méretek összeesnek a tetszőleges nanorendszerek méreteivel, ezért ideális eszköz a TEM a nanorendszerek vizsgálatára. A nanorendszerek azonban makroszkopikus formában jelennek meg, és ezekből a makroszkopikus mintákból kell készíteni a fenti vastagságú mintát a TEM-vizsgálathoz. Ennek az igen bonyolult feladatnak a legáltalánosabb megoldása az ionsugaras vékonyítás.
Szemben az elektronmikroszkópiával, egy nagyon speciális vékonyréteg-vizsgálati módszer az Auger mélységi feltérképezés, amely jelen formájában, megfelelő minták esetén, képes néhány atomi réteg vastag tartományok kémiai analizálására. Ebben az esetben is egy makroszkopikus mintát kell úgy kezelni, hogy az érdekes vékonyréteg a felületre kerüljön. Ehhez a művelethez is ionbombázást alkalmazunk.
A két módszer a közös vonása, hogy mindkettőnél a vizsgálat jóságát nem csak és főleg nem a mérőberendezés paraméterei, hanem a minta kialakításának minősége határozza meg. Tehát a nanorendszerek szerkezetkutatásában az ionbombázás igen előkelő helyet foglal el. Lássuk, miért?
A feladat, mint fent láttuk, az, hogy anyagot távolítsunk el egy felületről, de oly módon, hogy az esetlegesen sima felület eközben ne durvuljon sokat, a durva felület viszont simuljon ki. Itt számokat kell említeni. Egy tökéletesen tükröző felület a látható fény hullámhosszához képest sima. Ez néhány száz nanométer. De a nanorészecskék mérete néhány nanométer. Tehát egy szépen tükröző felület - nanoskálán - rendkívül durva is lehet. Az is könnyen belátható, hogy ha csiszolással szeretnénk létrehozni nanométeres durvaságú sima felületet, akkor a csiszolóanyagnak ebbe a tartományba kell esnie, ami nem mindig oldható meg, és még azzal is számolni kell, hogy bele is épülhet a felületbe. A kémiai marás alkalmazható, és vannak esetek, amikor alkalmazzák is, de itt is rengeteg a probléma a szelektivitással, a hibákra való érzékenységgel és főleg a végső, marószermentes felület kialakításával.
A nemesgáz ionokkal történő bombázás több problémát automatikusan old meg, de természetesen be is hoz új problémákat. A porlasztás lényegileg a felületi atomokat távolítja el, azaz ilyen értelemben a behatolása kicsi, és a nemesgáz bombázó ionok általában kémiailag nem kötődnek a bombázott anyaghoz. Ha megnézzük azonban egy polikristályos anyag felületét, amelyet szokásos ionbombázással marunk, tehát a beesési szög 45o és 60o között van, és az energia a szokásosan alkalmazott 1-5 kV, akkor azt látjuk, hogy a felület rendkívül durva lesz. Leginkább arra hasonlít, mint amikor egy folyó a puha kőzetbe mintázatot vág. Ennek oka az, hogy a porlasztási sebesség erősen függ az ionsugár és a krisztallit relatív orientációjának különbségétől. Súlyos problémákat okoz az is, hogy az eltávolított anyag egy része visszarakódik a felületre. Természetesen az is könnyen belátható, hogy adott szögviszonyoknál árnyékhatások fognak megjelenni, azaz lesznek olyan területek, ahova az ionok már nem tudnak behatolni, és lesznek olyanok, ahol a bombázás igen nagy hatékonyságú. Egy ilyen felület a fent vázolt feladatra természetesen abszolút alkalmatlan.
Ez az oka annak, hogy bár az ionvékonyítási módszert az ötvenes évektől alkalmazzák a TEM mintakészítéshez, az igazi áttörés a 80-as évek közepétől indult meg, csoportunk munkásságával (Barna, 1992; Barna et al., 1997) az ionsugaras vékonyítás területén. Ennek eredményeit azután az Auger mélységi feltérképezésben is átvettük (Barna - Menyhárd, 1994)
TEM minta készítése ionsugaras vékonyítással
Az ionbombázással történő mintavékonyítás ötlete igen egyszerű: bombázzuk a felületet, ennek hatására az anyag eltávozik, a minta vékonyabb lesz. A vékonyítás mértéke a belőtt ionok számával - ami könnyen szabályozható - arányos. Az ötlet megvalósítása azonban távolról sem egyszerű. A fő probléma abból ered, hogy az ionbombázás során a bombázott anyag eltávolítása csak az egyik folyamat. Sőt, ha azt tekintjük, hogy a belőtt energia mire fordítódik, meglepve tapasztaljuk, hogy nagyobb része az anyagban marad, ami ott nyilván változásokat okozhat. Hogy mennyi energia marad az anyagban, és az milyen változásokat okoz, az az ionbombázás körülményeitől függ. Érdekes módon, bár az ionbombázás igen régen ismert volt, a 80-as évek közepéig elég rossz eredményeket hozott. Ekkor kezdte Barna Árpád az ionvékonyításhoz kifejleszteni az ionágyút és vékonyítási metodikát. Hatására a módszer már igen jó minőségű mintákat állít elő (Barna, 1992; Barna et al., 1997).
Két oldalról közelítette a problémát, annak megfelelően, hogy az ionbombázás okozta változást is durván két részre lehet osztani: felületi morfológiaképződés és roncsolódás. Nyilvánvaló, hogy ez a két folyamat egymással kölcsönhatásban szimultán módon történik, mégis érdemes a tárgyalásukat különválasztani.
Az ionbombázás során történő felületi morfológia változása már igen régen ismert volt, és sok elmélet született a jelenség leírására. Jelenlegi tudásunk szerint általánosan használható elmélet a jelenség leírására nincsen. Ugyanakkor Barna Árpád megmutatta, hogy ha a felülethez képest súrlódó (0,5-3o a felülethez képest) irányú ionokkal bombázzuk a felületet, és a mintákat eközben forgatjuk vagy billegtetjük, hogy a kristálytani irányok szerint átlagoljuk, akkor nagy felületű sima mintát lehet előállítani. Elméletének helyességét számos TEM minta léte bizonyítja, illetve az, hogy ez lett az ionvékonyítás "szabványos" elrendezése az egész világon. Így tehát a felületi morfológia létrejöttét a fenti módon sikerült korlátozni.
Természetesen továbbra is igaz, hogy az anyageltávolítás mellett ennél a geometriánál is jelentősen roncsolják az ionok a mintát. Ezt mindenképpen meg kell akadályozni, mert nem egy roncsolt réteget, hanem az eredeti mintát kívánjuk vizsgálni. Ennek csak egy módja van: az ionenergiát csökkenteni kell. Itt azonban azzal kerülnünk szembe, hogy az ionenergia csökkentésével az anyageltávolítási sebesség igen erősen csökken. Meg kell azt is jegyezni, hogy már súrlódó beesésénél is igen kicsi az anyageltávolítás sebessége. E két információt összegezve arra jutunk, hogy a jó TEM minta előállítása olyan ionbombázási körülményeket igényel, amelyek mellett nem lehet az anyagot eltávolítani. Ezt az ellentmondást oldja fel a TELETWIN ionágyú (Technoorg), amely olyan nagy sugáráramot biztosít, hogy ezen igen kedvezőtlen bombázási körülmények között is lehet mintát vékonyítani vele.
Megépítése után az ágyú azonnal az érdeklődés homlokterébe került, amit az is mutat, hogy az összes, ezzel a témával foglalkozó gyár átállt a Barna Árpád által javasolt elrendezésre. Ennek ellenére ma is TELETWIN ionágyú és annak fokozatosan megjelenő javított új típusai (Technoorg Linda, Budapest gyártmány) a lehető legjobbak, amit az is mutat, hogy a világon eddig már több mint háromszáz laboratóriumban használják őket.
A mikroszkópos mintakészítés legnagyobb kihívása a keresztmetszeti mintakészítés, amely a vékonyréteg-rendszerek illeszkedési, szerkezeti tulajdonságait hivatott feltárni. A mintakészítés általában a következő módon történik. A mintából két darabot vágunk ki, amelyeket egymással szembefordítva befogunk egy csiszolható közegbe. A mintát mechanikusan kezdjük el vékonyítani, majd elérve egy megfelelő vastagságot, kerül az ionvékonyítóba. Itt a mintát forgatjuk vagy billegtetjük, az ionnyalábot felülethez képest súrlódó beesésbe állítjuk be. A szög 2 és 0,5o között változhat, és a mintát mind a két oldaláról vékonyítjuk. Ez a művelet egészen addig történik, amíg a minta valamely pontján átlyukad. Ekkor megállítjuk az ionvékonyítást. A súrlódó szög és a forgatás vagy billegtetés eredményeképpen egy kis görbületű kráter alakul ki. Ez azt jelenti, hogy a mintánk rendkívül sima és a kialakult kráter igen nagy felületen egyenlő vastagságú rétegnek tekinthető. A vékonyítás konkrét körülményeitől függően a minta vastagsága a néhány nanométer és a néhány 10 nm-es tartományban van az elektronmikroszkópos vizsgálatok igényeinek megfelelően.
Térjünk vissza ahhoz a kérdéshez, hogy az ionbombázás mindenképpen visz-e be hibákat az anyagba. Amint már láttuk, a hibák két részre oszthatók, az egyik csoportba a morfológiai, a másikba pedig a minta térfogatában keletkező hibák sorolhatók. Az előbbi eljárás - tehát a súrlódó beesésű bombázás és a minta forgatása vagy billegtetése - egy sima felületet eredményez. Pontosabban a minta kezdeti durvaságától és a krisztallitok relatív orientációjának különbségétől függően a morfológia változik a réteg eltávolítása függvényében. Egy adott rétegvastagság eltávolítása után beáll egy stacionárius állapot, ami adott hullámossággal és durvasággal jellemezhető. A megfelelő bombázási paraméterek kiválasztásával elérhető egy optimum. Ha a minta nem volt túl durva, és például egykristályos, akkor szinte atomosan sima felület érhető el. Polikristályos mintánál hullámos felület alakul ki, amelynek hullámosságát a kifejlesztett elméletünk alapján előre meg tudunk becsülni (Barna, 1992; Barna, 1997).
A másik problémaegyüttest a térfogatban kialakuló hibák jelentik, amelyek lehetnek ponthibák, Frenkel-hibák, stb. Több komponensű mintában keveredés történhet, azaz az egyik réteg atomjai átkerülhetnek a másik rétegbe és fordítva. A kristályszerkezet is deformálódhat. TEM-vizsgálatok esetében ez a hibás tartomány sokszor amorfizált rétegként jelenik meg. Mint említettük, a hiba azért keletkezik, mert a bombázó ionok energiájának döntő része nem porlasztásra fordítódik, hanem hibakeltésre. Bár a kölcsönhatási elméletek szerint a beesési szög súrlódáshoz való közelítésével a hibakeltés erősen redukálódik, azonban ez a megállapítás kísérleteink szerint 10o súrlódó beesési szög alatt nem érvényes. Végső soron a hibakeltést csak egy módon tudjuk eredményesen csökkenteni: az ionenergiát minél kisebbre kell választani.
A minta-előállítási idő optimalizálása érdekében nagyenergiás ionokkal kezdjük a vékonyítást, ezzel távolítjuk el az anyag döntő részét, majd amikor a minta vékonysága a kívánt közelében van, akkor fokozatosan csökkentjük az ionenergiát, és már csak simítjuk a mintát. Az igen jó minőségű felület előállításához a befejező simítást néhány 100 eV-os ionnal végezzük el.
Az ionsugaras vékonyítás eredményeinek összefoglalása valójában lehetetlen, hiszen mint említettük, több mint háromszáz laboratóriumban használják ezeket a berendezéseket, ami azt jelenti, hogy világszerte hetente több száz mintát állítanak elő ezzel a módszerrel. Kiemelünk azonban néhányat a laboratórium eredményei közül.
A kor követelményeinek megfelelően minden folyamatot automatizálni igyekszünk, kezdve a mosógéptől, az autókon keresztül a gyárakig. Az ehhez szükséges mikrochipek alapanyaga a szilícium. Az integrált áramkörök gyártása során rengeteg probléma merülhet fel, amelyek igen jelentős részét úgy próbálják megoldani, hogy elektronmikroszkóppal hibaanalízist végeznek. A minta-előállítás szinte kizárólag ionsugaras technikákkal történik.
A kutatók alapfeladata, hogy kiterjesszék ismereteink határait. Az elektronmikroszkóp atomoszlopok leképezésére alkalmas, persze csak akkor, ha nincs hibás réteg a vékonyított mintában. Az 1. ábra az első olyan TEM felvétel, ami a szilícium hibamentes atomelrendezését mutatja. A mintavékonyítást berendezésünkkel végeztük. Mind a mintavékonyítás, mind a TEM felvétel a kaliforniai Berkeley-ben, a National Center for Electron Microscopy; Lawrance Berkeley National Laboratoryban készültek. Ugyanilyen valós szerkezetet mutatunk természetes gyémántról a 2. ábrán.


Felvetődik a kérdés, mi történt a mintában kétségtelenül keletkező hibákkal? Ennek vizsgálatával foglalkoztunk egy másik cikkünkben (Barna et al., 1998), ahol azt vizsgáltuk, hogy a hibás, azaz a TEM szempontjából amorf réteg vastagsága hogyan függ az ionbombázás energiájától. Nagyon érdekes jelenséget tapasztaltunk. Azt vettük észre, hogy az ionenergia csökkentésével az amorf réteg vastagsága egy ideig kiszámítható módon változik. Viszont ha az energia átlép egy küszöbértéket, akkor az amorf réteg vastagsága erőteljesebben csökken. Ezt csak úgy tudtuk magyarázni, hogy a hibás kristály még szobahőmérsékleten is képes a gyógyulásra. Ez valójában nem meglepő, ha figyelembe vesszük, hogy a bombázással az egyensúlyitól igen távoli állapotot hozunk létre, amely az anyagnak nem kedvező, és így még szobahőmérsékleten is képes a kristályos állapot irányába történő változásokra. Valójában ez történik, amikor az ionenergiát 200-300 V-ra csökkentjük; ekkor anyagtól függően a roncsolt réteg vastagsága olyan kicsiny lesz, hogy mikroszkóppal már nem látható, és így az elektronmikroszkópos vizsgálatokat nem is befolyásolja. Valójában ez az a cél, amelynek érdekében ez a munka folyik.
Auger mélységi feltérképezés
Az Auger elektronspektroszkópia (AES) egy felületérzékeny analitikai módszer, melynek az a lényege, hogy elektronbombázással gerjesztjük az atomokat, amelyek jól definált energiájú Auger-elektronokat bocsátanak ki. Az intenzív Auger-vonalak az 50-1000 eV tartományba esnek. Az ilyen energiájú elektronok szabadúthossza a 0,5-1,5 nm nagyságrendbe esik, ami azt jelenti, hogy egy ilyen vastag rétegről hordoznak információt. Az AES megjelenésétől kezdve felmerült annak igénye, hogy ne csak a felületet, hanem a felület alatti tartományokat is vizsgálni tudjuk.
Az AES ultravákuum körülmények között működik, amelyben már kezdettől fogva használnak nemesgáz ionforrásokat. Ezek feladata atomi rétegek ionbombázással való eltávolítása. A korábbi megoldásokban az ionbombázási szöge 45-60o, az energia néhány 1000 eV volt, amiről már a 80-as években végzett kísérleteink kimutatták, hogy a vizsgálatok szempontjából a messze nem ideális tartományba esett.
Az Auger mélységi feltérképezés abból áll, hogy szakaszosan ionbombázzuk a felületet, és mérjük a frissen keletkezett felület AES spektrumát. A mélységi felbontás, azaz az észlelhető minimális határvastagság (a fenti bombázási körülményeket alkalmazva) nem volt túl jó. Érdekes módon, ahogy ez a tudományban nem ritka, az Auger mélységi feltérképezéssel foglalkozók nem ismerték az ionvékonyítási technológiát, és így azzal voltak inkább elfoglalva, hogy hogyan lehet az ionbombázás káros hatásait elméletileg leírni, mintsem az ionbombázás mikéntjét megváltoztassák. Anton Zalar (Zalar, 1985) volt az első, aki átvette az ionvékonyításban már ismert egyik technikát, ami természetesen forradalmi javulást idézett elő az Auger mélységi profilírozásban is. Zalar a mintaforgatást vezette be, és egyedül már ez is azt eredményezte, hogy a mélységi felbontás jelentősen megjavult. Most már világosan értjük, hogy ez azért következett be, mert a káros morfológia kifejlődése jelentősen lecsökkent. Laboratóriumunkban rendelkezésre állt az ionvékonyításhoz kifejlesztett ionágyú. Ez elsődlegesen nem volt alkalmas az Auger spektrometriai alkalmazáshoz, ugyanis az ionvékonyítás nagyvákuum és nem ultranagyvákuum körülmények között történik. Át kellett építeni tehát az ágyút az ultravákuum körülményeknek megfelelően. Ugyanakkor egy szokványos Auger-elektronspektroszkóp geometriai elrendezése nem engedi meg, hogy az ionbombázás az optimális feltételek mellett történjen. Ezért építettünk egy új kamrát, amelyben meg tudtuk valósítani a minta ionbombázás közbeni forgatását és a súrlódó beesésű ionbombázást úgy, hogy a bombázott felület in situ Auger-analízis helyzetben volt. Ebben a berendezésben nem csak Auger mélységi profilírozást lehet elvégezni, hanem valójában az ionbombázás során lezajlódó folyamatok egy részét in situ tudjuk vizsgálni. Ez azt eredményezte, hogy az ionbombázás során történő térfogati hiba keletkezésének mechanizmusait jobban megértettük, aminek egyik első eredménye volt, hogy meg tudtuk mondani, az ionenergia meddig csökkentendő. Megállapítottuk, hogy az ionkeveredés az ionenergia négyzetgyökétől függ, és így a kívánalmak függvényében ki lehet választani az optimális bombázási energiát. Természetesen mivel az Auger spektrometriában atomos szintű az érzékenységünk, a hibák sokkal súlyosabban jelentkeznek, mint az elektronmikroszkópnál. Ezért a hardver megváltoztatása mellett meg kellett változtatnunk a kiértékelési eljárást is.
A mért Auger-intenzitás súlyozott átlaga az atomok mélység szerinti eloszlásának. Ez azt jelenti, hogy egy mért intenzitásmértékből, ha nem ismerjük az atomok eloszlását, nem tudjuk megmondani, hogy hány atomból származik a kibocsátott jel. Ez természetesen nem probléma akkor, amikor például tudjuk, hogy a felületen van egy atomi rétegnél kisebb mennyiségű szegregált atom, mert azok csak a felületen lehetnek, s akkor az atomok eloszlása meg van adva, s így meg tudjuk adni számukat. Ugyanígy nem volt probléma akkor sem, ha a "hagyományos" ionvékonyítást alkalmaztuk, mert az a kedvezőtlen bombázási körülmények miatt egy 2-8 nm vastag kevert réteget hoz létre, amelyben a koncentrációk kvázi állandók. Azzal, hogy az ionbombázás körülményeit úgy változtattuk meg, hogy a roncsolt réteg vastagsága már kisebb, mint az Auger-elektronok információs mélysége, sajnos vagy szerencsére az atomok eloszlását is figyelembe kell venni az AES spektrumok kiértékelésénél.
Az ionbombázással létrehozott felületi réteg analízise úgy végezhető el, hogy elsődleges becslést adunk az atomok eloszlására. Ennek lehetséges módja a következő (Menyhárd, 1998). Az ionbombázás által létrehozott változásokat elméleti úton leírjuk. Ennek módja, hogy az irodalomban ismert valamely elméletet alkalmazva, a kísérletnek megfelelően szimuláljuk az anyageltávolítás folyamatát. Feltételezünk egy kiinduló minta szerkezetet, a szimulációval leírjuk az ionbombázás hatását, és egy második szimulációval kiszámoljuk a várható Auger mélységi profilt. Ezt összehasonlítjuk a mérttel, és addig változtatjuk a kiindulási minta szerkezetet, amíg az egyezés kielégítő nem lesz. Erre a kiértékelésre azért van szükség, mert ahogy azt már említettük, a technológiailag és gyakorlatilag fontos mintákban a rétegvastagságok is és a roncsolt réteg vastagsága is a néhány nanométeres tartományban van. Egy ilyen vastagságú rétegben mindenképpen keletkeznek hibák az ionbombázás hatására, bármilyen alacsony bombázóenergiát alkalmazunk is.
Illusztrációként egy tipikus vizsgálat eredményét mutatjuk, amely a szokásos ionbombázási módon nem végezhető el. A minta egy óriás mágneses ellenállású (spin valve, SV) réteg. Ezeket a rétegeket használják a merevlemezek olvasófejeiben, s valójában e rétegek nélkül lehetetlen a nagysűrűségű információk olvasása. Egy ilyen vékonyrétegszerkezet lelke három igen vékony réteg; két mágneses réteg (Co) van elválasztva egy nem mágneses (Cu) réteggel. Természetesen nem megyünk bele az óriás mágneses ellenállás magyarázatába, csak azt jegyezzük meg: bizonyos vastagságok szükségesek a fenti rétegeknél, hogy a rétegrendszernek tényleg nagyon nagy legyen a mágneses ellenállás változása akkor, ha a mágneses tér megváltozik. Egy működő rétegrendszer olyan például, hogy a két kobaltréteg vastagsága 1 nm, míg a rézréteg vastagsága 2,3 nm.
A rétegrendszer akkor lesz jó, ha a határfelületek élesek és atomosan simák, a kémiai koncentráció hirtelen változik meg. Ezeket a rétegeket természetesen mágneses mérésekkel jellemzik, és a mágneses ellenállás értéke a fontos paraméter. Ha elkészül egy minta, és a mágneses ellenállása nem megfelelő, nehéz megmondani, hogy mi a probléma. A jelen esetben az történt, hogy a gyártók (Kodak) próbálgatással rájöttek: a porlasztással létrehozott rétegrendszert hőkezelni kell ahhoz, hogy nagy értékű legyen a mágneses ellenállása. Kérdés, miért? Igen sok vizsgálat mellett szerkezetvizsgálatot is végeztünk. A keresztmetszeti TEM-szerkezetvizsgálatok ezeken a rétegrendszereken igen nehézkesek, hiszen a Co és Cu rendszáma igen közel van, s a relatív kontraszt nagyon kicsi. Ezeket a vizsgálatokat elvégeztük laboratóriumban, és csak annyit sikerült megállapítani, hogy a határfelületek nem túl durvák. Ugyanakkor a TEM-vizsgálat arra már nem alkalmas, hogy néhány atomi rétegen belüli keveredést kimutasson. Auger mélységi feltérképezéssel vizsgáltuk ezeket a mintákat. A hőkezelt minta esetében 700 eV ionbombázást alkalmazva a 3. ábrán látható Auger mélységi profilt kaptuk (a profilnak csak a SV-re vonatkozó részét mutatjuk). Bár a mérési eredmény szépen mutatja, hogy rétegrendszer van, azt ebből nem tudjuk megállapítani, hogy a határfelületek élesek-e. Az Auger-elektronok szabadúthossza, amit az analízisben felhasználtunk, 1-1,5 nm, ami több mint a rétegvastagság, tehát nem is várhatunk éles profilt. Kiértékelési módszerünket alkalmazva a 4. ábrán látható kezdőállapot esetében a 3. ábrán mutatott szimulált profilt kapjuk, ami jól egyezik a mérttel. Ez azt jelenti, hogy a hőkezelés után a rétegrendszer valójában jó minőségű. Az 5. ábrán összehasonlítjuk a minta szerkezetét (amit méréseinkből határoztunk meg) a hőkezelés előtti és utáni állapotban. Jól látszik, hogy a határrétegek kevertek voltak a készítés után, és a hőkezelés ezt a keveredést jelentősen csökkentette, ami a mágneses ellenállás növekedését eredményezte. Vegyük azt is észre, hogy az anyagátrendeződés a 0,3-0,5 nm tartományban történt, amit módszerünkkel ki tudtunk mutatni.
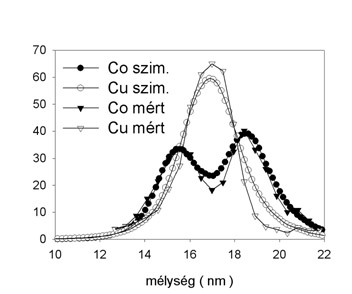

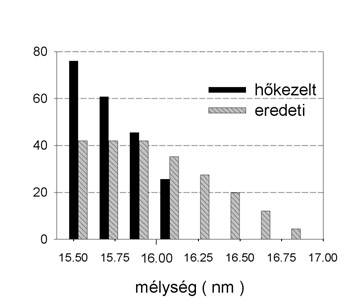
Kitekintés
A nanotechnológia és vékonyréteg-technológia fejlődésével úgy tűnik, hogy a két fent említett módszer egyre több alkalmazásba kapcsolódik be. További előnyt jelent, ha ezek a módszerek közvetlenül összekapcsolhatók más mérési eljárásokkal is. Ezek közül most a legfontosabbnak a különböző pásztázó mikroszkópos eljárásokat gondoljuk. Egész sor technikai problémát kell megoldani ahhoz, hogy egy ionbombázott mintán, vagy egy olyanon, amelyen Auger mélységi profilírozást végeztünk, például atomi erő mérést is tudjunk végezni. Ennek egy része, hogy rögzítenünk kell a vizsgálat helyét, a másik része, hogy ezt a vizsgálati helyet meg kell találnunk az atomi erő mikroszkópban is. Ennek a feladatnak a megoldására az intézet elnyert egy pályázatot (3/0064 sz. NKFP3), amelynek révén már tudtunk atomi erő mikroszkóp vizsgálatot végezni Auger mélységi profilírozással előállított határfelületen. Ennek igen szép eredménye (Barna et al., 2003), hogy megmutattuk, a bombázási sebességek különbözősége esetén reverzibilis határfelületi durvulás tapasztalható. Ez a példa azt mutatja, hogy egy komplex vizsgálathoz alapvetően szükséges különböző módszerek szimultán vagy egymás utáni alkalmazása.
Kulcsszavak: TEM mintakészítés, Auger mélységi feltérképezés, ion-bombázás indukált roncsolódás
Irodalom
Barna Árpád (1992): Topographic Kinetics and Practice of Low Angle Ion Beam Thinning, in Proc.Fall Meeting MRS, 1991, in Proc. Fall Meeting MRS, 1991, Boston, Workshop on Specimen Preparation for Transmission Electron Microscopy of Materials-III, MRS Conf. Ser. Vol. 254. 3-22.
Barna Árpád - Radnóczi György - Pécz Béla (1997): in Amelinckx, Severin - van Dyck, D. - van Landuyt, J. - van Tendelo G. (eds.) in Handbook of Microscopy. VCH Verlag, Vol. 3, Chapter II/3, 751-801.
Barna Árpád - Menyhárd Miklós (1994): Auger depth profiling of deeply buried interfaces. Physica Status Solidi. (a) 145. 263.
Barna Árpád - Pécz Béla - Menyhárd Miklós (1998): Amorphisation and Surface Morphology Development at Low Energy Ion Milling. Ultramicroscopy. 70, 161-171.
Barna Árpád - Menyhárd M. - Zsolt G. - Zalar A. - Panjan, P. (2003): Interface Broadening Due to Ar+ ion Bombardment Measured on Co/Cu Multilayer at Grazing Angle of Incidence. Journal of Vacuum Science and Technology. A 21. 553-557.
Menyhárd Miklós (1998): On the Performance of the TRIM Simulation for the Evaluation of Auger Depth Profiles. Surface and Interface Analysis. 26. 1001-1007.
Zalar, Anton (1985): Improved Depth Resolution by Sample Rotation during Auger Electron Spectroscopy Depth Profiling. Thin Solid Films. 124. 223-230